晶圆(Wafer)清洗分为湿法清洗和干法清洗,等离子清洗属于后者,处理时主要是去除晶圆表面肉眼看不到的表面污染物。在清洗过程中会先将晶圆放入等离子清洗机的真空反应腔体内,然后抽取真空,达到一定真空度后通入反应气体,这些反应气体被电离形成等离子体与晶圆表面发生化学和物理反应,生成可挥发性物质被抽走,使得晶圆表面变得清洁并具亲水性。那么,这种方式处理的晶圆封装等离子清洗机又有哪些特点呢?
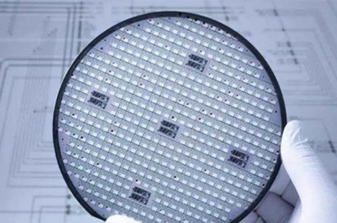
等离子清洗晶圆是在千级以上的无尘室中进行的,对particle的要求极高,任何超标的particle存在,都会造成晶圆不可挽回的缺陷。所以设计等离子清洗机的腔体设计我们会选择铝质,而不是不锈钢材质。摆放晶圆的托架滑动部分,要尽量采用不容易产生粉尘和被等离子腐蚀的材料,电极和托架也要方便拆卸,便于日常维护。
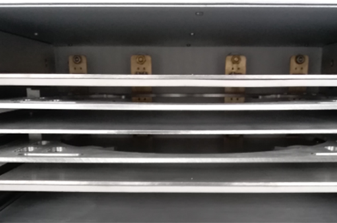
而晶圆级封装(WLP,Wafer Level Package)是先进的芯片封装方式之一,即整片晶圆生产完成后,直接在晶圆上面进行封装和测试,然后把整个晶圆切割开来分成单颗晶粒;电气连接部分采用用铜凸块(Copper Bump)取代打线(Wire Bond)的方法,所以没有打线或填胶工艺。
在晶圆级封装时,我们需要的处理目的是去除表面的无机物,还原氧化层,增加铜表面的粗糙度,以提高产品的可靠性。而在芯片制作完成后残余,的光刻胶无法用湿式法清洗,只能通过等离子的方式进行去除,然而光刻胶较厚无法确定,所以还需要去调整相应的工艺参数。

包括等离子清洗机反应腔体内的电极间距和层数,以及气路分布,对于晶圆处理的均匀性都重大的影响等等,这些指标都需要不断试验来优化。
最后我们若是想要观察处理之后的晶圆产品效果是达标,可以简单通过观察水滴角的方式来判断。




