1、Wire Bonding(引线键合)和Flip Chip(倒装芯片)的工艺特点
为了实现芯片封装的工艺,常见的互联方式主要有两种,分别是Wire Bonding(引线键合)和Flip Chip(倒装芯片)。其中的引线键合工艺有着两个步骤,第一步是先要把芯片粘结在载板上,实现物理连接;到第二步的操作其实就是引线键合,即该工艺的关键了。在这一步骤中可以实现电性连接。而倒装芯片工艺则没有分成两个步骤,只需一个步骤即可同时实现物理连接和电性连接。在这里我们将主要介绍在引线键合工艺当中的两种键合工艺。
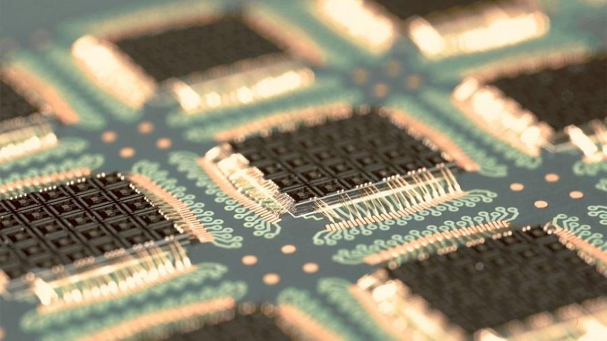
2、楔焊(Wedge Bonding)
为了实现芯片与载板的引线键合,通常采用的键合方法主要有热超声焊、热压焊、超声焊,而材料有金线、铜线、铝线等。在这里引线键合根据键合点焊接形式不同,可以分为两种:第一种为球焊(Ball Bonding,一般也称为Ball-Wedge Bonding),常用金线和铜线作为焊材,这种焊接形式的特点是第一焊点是焊球,通过热超声会使得焊丝与芯片的金属pad融接。第二点为鱼尾(stitch),通过热超声焊会将焊丝压接在载板上:而第二种是楔焊(Wedge-Wedge Bond),在这种焊接形式中第一焊点和第二焊点都是通过超声压分别与芯片和载板焊接的,常用的焊材微铝线和金线。其中对于楔焊来说,其焊线长度相对较短,电阻电感小,非常有利于高频信号和大电流通过。
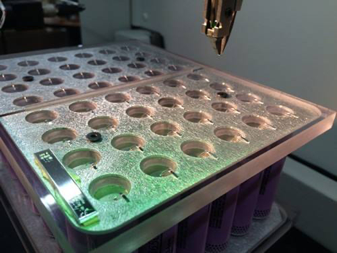
在这些焊材当中,目前金线、铜线的直径一般不超过50um,而铝线直径则从50um到500um不等。其中金线常用在高速高频信号芯片的键合上,如射频微波芯片、光芯片等;而铜线、铝线则常应用在大功率、大电流的芯片焊接上,如IGBT。就焊材的特点而言,金线焊接的工艺成熟,但成本较高,在商用领域有被铜线取代的趋势。而铜线导电性好,价格便宜,缺点主要是硬度太大,键合时需要更大的压力,容易对芯片造成伤害,而芯片加工产业又有着精细程度较高的工艺需求。但随着铜线键合工艺的成熟,此缺点正在慢慢被克服。
3、带式键合(Ribbon Bonding)
除上述两种常见的键合方式,还有一种带式键合(Ribbon Bonding)存在,其键合过程与楔焊类似,但焊材不是线状,而是带状的,主要的焊材为金带和铝带。之所以选择带状的焊材,主要是由于金属带比较宽,可以提供更小的电阻和电感。其中铝带主要应用在产生大功率的环境中,金带则应用于射频微波器件上。

昆山普乐斯电子14年专注于等离子表面处理工艺研究,专业的等离子清洗机设备生产厂家,在等离子清洗机、大气低温等离子表面处理系统、大气常压等离子清洗机设备、真空等离子清洗机等等设备都有多年生产经验;如果你有等离子表面处理的需求,欢迎联系普乐斯,在线客服或者拨打全国服务热线400-816-9009,普乐斯随时为你服务哦!





